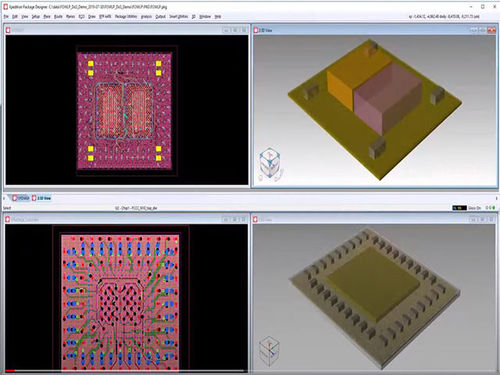

- Produits
- Catalogues
- News & Trends
- Salons
Logiciel d'interface Xpedition Packagede qualitéd'automatisationde commande
Ajouter à mes favoris
Ajouter au comparateur
Caractéristiques
- Fonction
- d'interface, de qualité, d'automatisation, de commande, de conception, de création, d'édition, de contrôle, embarqué
- Type
- temps réel, 3D, automatisé, 2D-3D
- Autres caractéristiques
- haute performance
Description
Mise en œuvre physique de substrats hétérogènes et homogènes et transfert de fabrication pour les circuits intégrés 2,5/3D en fonction des contraintes.
Implémentation physique et transfert de la fabrication
Conception d'interposeurs de boîtiers de semi-conducteurs avancés et de substrats, y compris FOWLP, ABF, 2,5/3D, silicium, noyau de verre, ponts intégrés ou surélevés, systèmes en boîtier et modules.
Principales caractéristiques de Xpedition Package Designer
Expérience utilisateur (UX) moderne infusée par l'IA
Structures de menu normalisées et interface utilisateur/UX enrichie d'IA et de ML pour prédire et recommander des opérations afin d'accélérer la productivité des concepteurs.
Empilement de dispositifs pour les intégrations 2.5/3D et SiP/Module
Construisez et gérez des assemblages de dispositifs complexes tels que des circuits intégrés 3D, des empilements côte à côte et des empilements multiples de différentes hauteurs. Prise en charge complète des dispositifs/dispositifs intégrés à double face, tels que les configurations d'interposeur/de pont, y compris la prise en charge des dispositifs intégrés actifs et passifs.
Prise en charge complète des modules SiP
Concevez et vérifiez des modules SiP complexes dans un environnement de conception 3D entièrement pris en charge. Edition 2D/3D et DRC simultanées dans un seul outil de conception qui détecte et évite facilement les problèmes de conception liés à la 3D. Wire bonding complet en temps réel pour les empilements multi-pièces les plus complexes avec des profils de fil définissables par l'utilisateur, avec prise en charge des technologies numériques, analogiques et mixtes.
Routage de signaux et d'interfaces haute performance
Implémentation rapide des interfaces HBM avec pas/répétition automatique des canaux, y compris la compensation automatique des broches hors pas. Planification et routage rapides des chemins de données grâce à la technologie brevetée de routage automatisé Sketch. Réglage automatique intégré des performances des réseaux SI avec blindage automatique des paires différentielles et des réseaux asymétriques.
---
Catalogues
Aucun catalogue n’est disponible pour ce produit.
Voir tous les catalogues de SIEMENS EDARecherches associées
- Solution logicielle d'automatisation
- Solution logicielle de gestion
- Solution logicielle d'analyse
- Solution logicielle de process
- Solution logicielle Windows
- Logiciel de CAO
- Solution logicielle de commande
- Solution logicielle temps réel
- Logiciel en ligne
- Solution logicielle de conception
- Solution logicielle 3D
- Logiciel d'interface
- Logiciel pour l'industrie
- Logiciel de mesure
- Logiciel de qualité
- Logiciel de simulation
- Solution logicielle de visualisation
- Logiciel automatisé
- Solution logicielle de développement
- Solution logicielle de réseau
* Les prix s'entendent hors taxe, hors frais de livraison, hors droits de douane, et ne comprennent pas l'ensemble des coûts supplémentaires liés aux options d'installation ou de mise en service. Les prix sont donnés à titre indicatif et peuvent évoluer en fonction des pays, des cours des matières premières et des taux de change.





